专题-2: Unit Process–ThinFilm(转)
本文转自芯苑,ic-garden.cn (由于芯苑会经常关闭站点,故转载存留)
ThinFilm(薄膜)主要包含CVD和PVD,CVD(Chemical Vapor Deposition)主要依靠反应气体在等离子体电离能量下,化学分解反应,主要用语后端温度比较低(~400,450C)。而PVD(Physical Vapor Deposition)主要是用来金属沉积,因为很少有金属的气态化合物分解产生单质金属,除了MOCVD的钨(W)和Damascene的铜(Cu)制程。主要依靠直流溅射顶部的金属靶材是的金属原子撞击落下。
CVD的几个重要参数(下corner 90度,上corner 270度,表面180度,所以沉积速率不一样导致):
1、侧壁Step Coverage: 底部最薄处除以顶部厚度比值 (b/a)
2、底部Step Coverage: 底部最薄处除以顶部厚度比值(d/a)
3、保角性(Conformity): 底部厚度除以上corner厚度 (b/c)
4、肩膀突出(Overhang): 上肩膀厚度减去底部侧壁厚度之差除以底部厚度(c-b)/b
5、纵宽比(Aspect Ratio):金属高度除以space(h/w),用于衡量gap fill能力。
6、D/S ratio (deposition/Sputter) : 常用于HDP的制程,因为通常的CVD在上口先封口,所以会产生空洞,必须在沉积过程中有plasma轰击是的上口的封口打开。
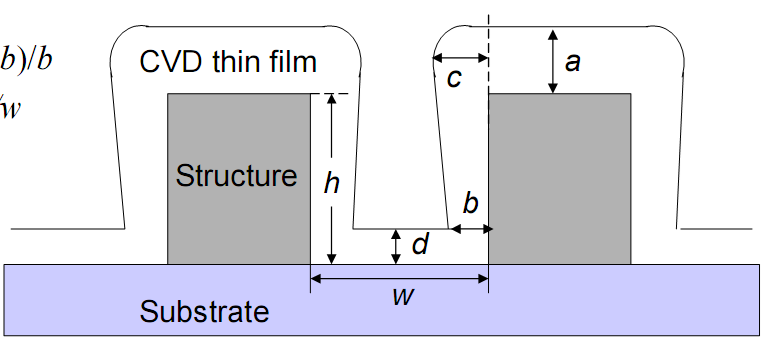
各种film的summary:
这里面还没有包含Low-K物质,FSG的介电常数~2.7,在0.18um以下制程会降低金属互连的电容,减小R*C delay。

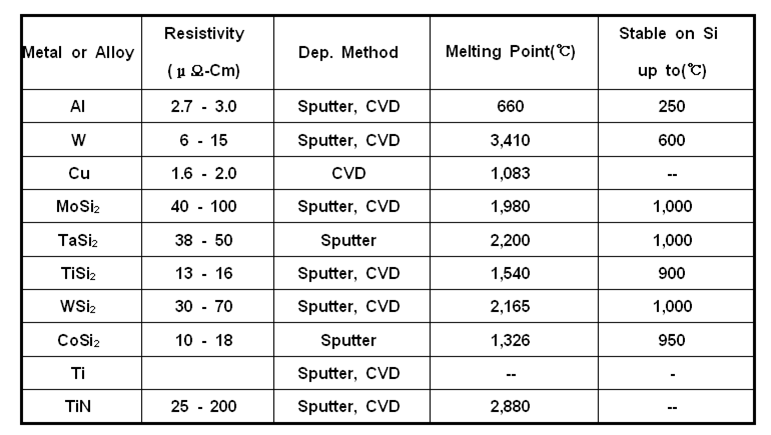
《专题-2: Unit Process–ThinFilm(转)》.doc
将本文下载保存,方便收藏和打印
导出文档

 支付宝打赏
支付宝打赏  微信打赏
微信打赏