微影制程之Overlay控制(转)
本文转自芯苑,ic-garden.cn (由于芯苑会经常关闭站点,故转载存留)
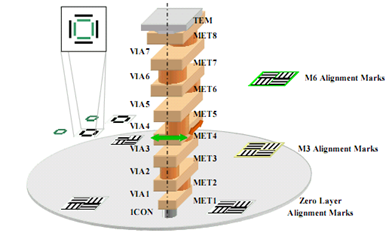
乘着兴致,把黄光讲完吧,估计我也就懂这些了,我没讲到的期待有人能够补充发表,感谢。
其实光刻的重要衡量参数就两个,一个是特征尺寸(CD),一个是对位控制(Overlay)。今天我们讲解的东西就是对位,顺便讲下光罩。
1、首先讲对位(Alignment):现在的IC制造工艺非常复杂,需要用到三十几层光罩,除了第一层光刻外,其他每一层曝光前必须要将该层图形对准前层留下的图形。当然对位系统包涵两个部分,一个叫做Mask对位系统(指Mask与Stage之间),一个叫做wafer对位系统(Mask与Wafer之间),我们这里只讨论Wafer对位系统。
1) Nikon机台:主要用LSA、FIA对位系统,
a.) LSA (Laser Step/Scan Alignment),它是一个暗场下的衍射光或散射光的侦测系统。对位激光光束相干性的特点,决定了这种对位系统的高灵敏度及高识别能力,它适合于大多数的层次且throughput比较大,尽可能多多使用。但在铝层,在结晶颗粒比较大的时候,精确性会受到限制。在EGA (增强全局对位)对位技术里,虽然这种结晶颗粒产生的随机错误的影响可随对位点的数量增加而得到一定的改善;但由于激光束的相干性是固有的,因此,对位标记的非对称性引起的对位错误在EGA中是得不到改善的。(还有一个类似的叫做LIA的东西,Laser Interferrence Alignment,与LSA相似吧,只是它用的是零极光对位,而LSA是用一级光对位。)
b.) FIA(Field Image Alignment),用于圆片对位,在G7/I7系列开始采用。它以图象方式读取圆片上的对位标记并对图象进行处理,检测标记的位置。LSA的光源为He-Ne激光器,而FIA的光源为宽带的相干性差的卤素灯。由于LSA方式采用的是干涉原理,在涂胶时的胶厚不均匀或对位标记的形状差异易引起的缩放错误以及圆片表面的粗糙(如铝层)易引起随机错误等情况下对位的精度不好,FIA方式由于采用了宽频非相干的光源照明、明场成像可以克服这些不利因素。FIA系统其实是类似ASML的离轴的对位系统,在完成对位时,光路并没有通过透镜组,而是位于透镜组的旁边。这是由于不同波长的光波在透镜中不同的折射率引起光程差的差异,因此这种宽频的非相干是不能通过透镜组的。

2) ASML机台:它主要用它两组眼睛设计好的光栅(Grating)来进行对位(也是他们公司的Logo),自己去google吧,我也讲不清楚了,以前没搞过scanner,现在也懒得学了。但是这个东西不能放在Scribe line里,所以必须在Wafer上要有“眼睛”。(真麻烦,要不是它对位最准,估计早被淘汰了。人家Nikon的Mark就可以直接放在Scribe line里)
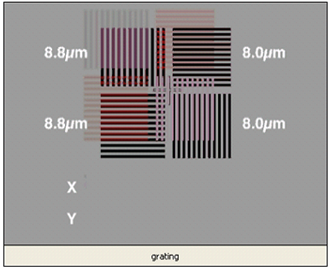
然后他的对位系统有两种,一种是直接用0级光通过Lens和孔径(NA)来探测的叫做TTL(Through the Lens),还有一种是离轴光(OAI: Off-Axis-Illumination),为啥比较准我也不知道,应该是用1级光吧,貌似光级越高越精准啥的,别信我了去问黄光制程或者google吧,这个我真不懂,呵呵。
TTL由于他的衍射比较严重,所以它的resolution和DOF都比较差,而OAI由于Pattern deformation和Lens Aber效应所以提高了resolution和Focus,但是Throughput降低了。
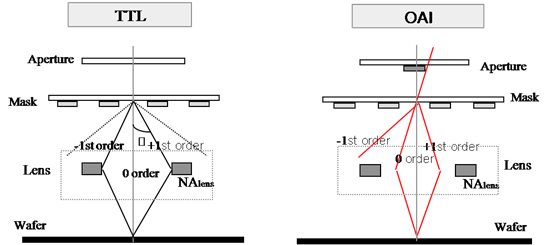
讲完了Alignment,自然就要将如何衡量Alignment结果,所以我们有Overlay量测。
1) 游标(Vernier),这是最古老的了,那时候跟闻正峰学了很久(瓶子和棒棒),在6寸时代就是培训线上小姐读游标,这个方法好哇,不用机器就可以量测,只是精度差,原理等同于游标卡尺的方法(中间一根正好对位,后面每0.05um一个偏差,以此累计类推,实际过程中肯定中间对不好,那就数看第几个对上了就乘以0.05um就好了,自己对照下图数吧~~)
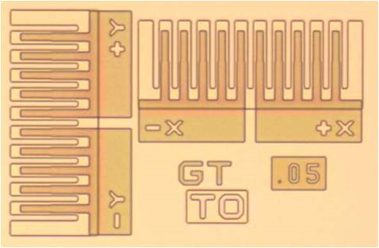
2) 量测框(OVL Box),这几个是用来给机器量的,分两种一种叫做"Bar-in-Bar",一种叫做"Box-in-Box"。设计如下图,至于原因我也不知道,不过现在比较多用Box-in-Box。
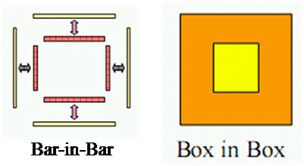
实际测试过程是每个wafer测五个shot,每个shot的box测试四角,一共有20个data,根据这20个data得出不同种OVL状况,确定是Mask旋转(rotation)还是跑偏(Translation)还是放大(Magnification)等造成的OVL问题,当然最后目的是为了补偿。

好吧,今天就讲到这吧,看来Mask讲不完了,留着明天继续吧~~

 支付宝打赏
支付宝打赏  微信打赏
微信打赏