pMOSFET的可靠性-NBTI (转)
本文转自芯苑,ic-garden.cn (由于芯苑会经常关闭站点,故转载存留)
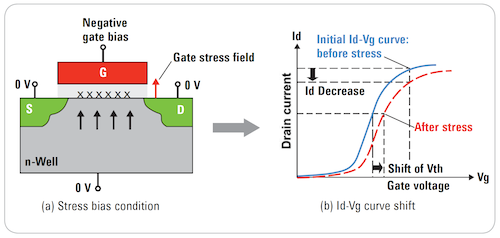
当我们提起NMOS的可靠性的时候,大家随口就说HCI (Hot Carrier Injection),她主要是由于短沟道效应导致的电子碰撞产生电子空穴对,而空穴被垂直栅极电场推进了substrate就成了Isub,而电子被Inject到gate端,与Si/SiO2的界面Si-H键碰撞使得Si-H键破裂重新产生界面陷阱电荷(Dit),但是NMOS的Dit是产生在靠近Drain端的Gate OX哦,因为那里是pinch-off点,载流子最多碰撞几率最高。当然HCI只适用于NMOS,因为只有电子才有足够的动能(E=1/2*mV^2,公式里面速度比重量更重要),所以只有热电子撞击晶格才能产生电子空穴对(Impact Ionization),而她的表征参数就是Isub。(留给大家两个问题,第一个为什么Isub总是约等于1/2Vdd?第二个问题为什么Isub-Vg曲线总是先上升,然后再下降?甚至LDMOS还有有第二个峰?)
那么PMOS呢?难道她就不会decade?当然不是!虽然PMOS没有热电子,但是PMOS也有gate垂直电场,当PMOS工作在反型区(Vgs<=0)的时候沟道开启的空穴难道就不会被拉上去吗?理论上会,而且随着温度升高她还会更严重,所以这就是NBTI (Negative Bias Temperature Instability),但是这个理论之所以一直没有被工业界考虑(至少比HCI晚10年,因为NMOS HCI在sub-micron时代就出问题了,但是PMOS到0.25um/0.18um才开始出现),主要是因为0.35um时代以前都是buried channel,所以空穴还不能直接inject到GOX interface,但是到了0.25um/0.18um GOX变薄导致电场增强,GOX用湿氧,GOX掺NO等这些都是NBTI的杀手。
所以说NBTI从结果论来看,对栅极的危害和NMOS类似,都是产生了界面电荷导致了PMOS Vt变慢。只是形成机理不一样,PMOS是栅极电场并且搭配温度而已。还有一点要注意,和NMOS不一样的是PMOS是产生在整个沟道区。(下图a为NBTI,图b为HCI)
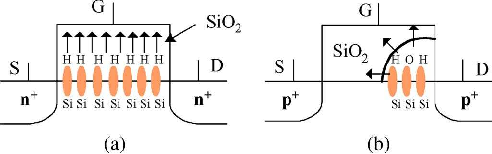
NBTI的模型理论我也不懂,但是很多文章都说了R-D Model (Reaction-Diffuse),白话文就是Si-H的破裂变成H/H2然后diffuse出去的过程。她的过程大概可以分分解为:Hole到Si/SiO2 -> Si-H键破裂 -> "H"扩散到SiO2或Bulk ->Dit的产生。所以类似氧化的模型刚开始是Si-H破裂主导,后来到H/H2扩散主导。公式我就不讲了,也讲不清楚。
根据定性的模型讲解,NBTI和什么东西有关?首先是沟道长度L,长度越长越严重。其次是Idsat比Idlin严重,第三个是薄GOX比厚的严重。大家自己想一下吧,我也是自己想的。
NBTI的恢复特性,一般情况下,当应力结束(Vg为正)的时候,退化特性又会恢复,时间越长恢复越彻底,这主要是刚刚裂解的“H”又过来填补了Dit,但是如果那个H跑太远了就回不来了也就无法恢复了,所以温度越高越难恢复。
NBTI的影响因素?氮元素会降低Si-H的激活能,主要是Stress问题,所以界面尽量减少"N"浓度不过等离子氮化制程是例外哦,她是可以抑制NBTI的。另外还有“F”也会改善NBTI,她主要是释放界面应力,切Si-F键比Si-H键更稳定。另外一个比“Si-H”键更稳定的是Si-D (氘/dāo, 氢的二价同位素),氘因为有一个中子,所以她质量更大更稳定,理论上用她来alloy会更好,只是她不适合用在process里。另外boron penetration也会使得NBTI更不好,因为GOX也会吸硼排磷进入到GOX的boron使得GOX生长的Si-O键不完整产生Dit。
好吧,到此讲完了!最后分享一篇NBTI的权威文章,我看过很多paper都是应用这一篇。<How do we understand NBTI?>。

 支付宝打赏
支付宝打赏  微信打赏
微信打赏