[原创]碳化硅功率器件制造工艺详解
好的,我们来详细解释一下碳化硅(SiC)功率器件制造工艺中的核心材料——碳化硅同质外延片,以及您提到的关键概念和工艺。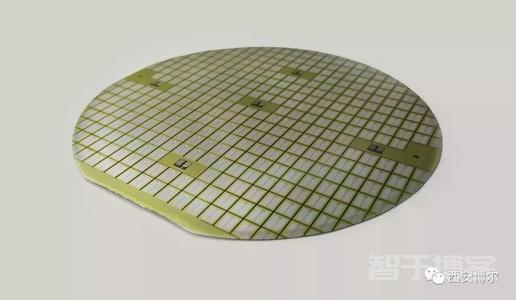
核心概念解析:
4H-SiC:
- 这是碳化硅最常见的多型体(晶体结构的一种变体)之一,用于功率器件制造。
- “4H” 指的是其晶体结构的堆垛顺序:沿着 c 轴方向,每 4 个 Si-C 双原子层构成一个完整的六方晶胞周期(ABCB 堆垛顺序)。
- 优点: 4H-SiC 具有宽禁带(
3.3 eV)、高临界击穿电场(2-3 MV/cm)、高热导率(4.9 W/cm·K)和高饱和电子漂移速度(2.0×10⁷ cm/s)。这些优异的物理特性使其非常适合制造高压、大电流、高温、高频、低损耗的功率半导体器件(如 MOSFETs, JBS Diodes, IGBTs 等)。
晶面取向与表面终止:Si 面 vs. C 面
- 在六方晶系的 4H-SiC 中,最重要的晶面是 {0001} 面族。
- 正轴 (On-axis) vs. 偏轴 (Off-axis):
- 正轴 (0001) 衬底: 晶圆表面严格平行于 (0001) 晶面。这种表面在原子尺度上是“完美”平坦的(基面)。
- 偏轴 (Off-axis) 衬底: 晶圆表面与 (0001) 基面存在一个小的倾斜角(通常是 3.5° 或 4°,方向朝向
<11-20>)。这是 目前 SiC 同质外延的主流选择。偏轴切割破坏了表面的完美平坦性,在微观上形成一系列原子台阶(Atomic Steps)。
- Si 面 vs. C 面:
- 这是指 {0001} 面族中两个极性相反的晶面:
- (0001) 面: 也称为 Si 面。这个表面最外层的原子是硅(Si)原子。Si 原子有未饱和的悬挂键(指向晶体外部)。
- (000-1) 面: 也称为 C 面。这个表面最外层的原子是碳(C)原子。C 原子有未饱和的悬挂键(指向晶体外部)。
- 关键区别:
- 化学活性: C 面通常比 Si 面具有更高的化学反应活性。
- 氧化速率: C 面的热氧化速率显著高于 Si 面。
- 外延生长特性: 在标准 CVD 工艺下,Si 面 的外延生长更容易控制,能获得更高质量的外延层(更低的缺陷密度,尤其是三角形缺陷)。C 面 的生长速率通常更快,但更容易产生缺陷(如多型夹杂、3C-SiC 岛),且掺杂控制更困难。因此,目前商业化的 SiC 功率器件几乎全部采用 Si 面偏轴衬底进行外延生长。
- 这是指 {0001} 面族中两个极性相反的晶面:
台阶流生长 (Step-Flow Growth):
- 这是 在偏轴 SiC 衬底上进行高质量外延生长的关键模式。
- 原理:
- 由于衬底偏轴,表面形成一系列平行的原子台阶(高度通常是一个双原子层高度,约 0.5 nm)和平台(Terrace)。
- 在化学气相沉积(CVD)外延过程中,气相前驱体(如 SiH₄/SiH₂Cl₂ + C₃H₈/C₂H₄)分解产生的吸附原子(Si 和 C 原子)会扩散到衬底表面。
- 这些吸附原子优先在台阶边缘(Step Edge) 处结合并入晶格,因为那里的悬挂键密度更高,结合能更大。
- 随着原子不断在台阶边缘结合,整个台阶会沿着平台的方向(通常垂直于台阶边缘方向)横向移动,就像水流一样。新的台阶会不断形成并移动。
- 优点:
- 抑制二维成核: 迫使生长主要发生在台阶边缘,大大降低了在平台区域形成新二维晶核(可能导致缺陷)的概率。
- 降低缺陷密度: 是获得低缺陷密度(特别是降低基平面位错 BPD 向贯穿螺位错 TED 转化、减少三角形缺陷)的关键机制。
- 表面平整: 能生长出表面非常光滑、原子级平整的外延层。
- 必要条件: 衬底偏轴角度、生长温度、反应气体分压/流速(V/III 比)等参数必须精确控制,以保证吸附原子的表面扩散长度大于平台宽度,使其有足够的机会迁移到台阶边缘结合。
点击阅读全文
《[原创]碳化硅功率器件制造工艺详解》.doc
将本文下载保存,方便收藏和打印
导出文档
