专题-1: Unit Process–Photolithography (转)
本文转自芯苑,ic-garden.cn (由于芯苑会经常关闭站点,故转载存留)
随着半导体特征尺寸(Moore's Law)下降,需要越来越小的波长得到更小的曝光线宽(大波长容易衍射)。5、6寸时代都是g-line/i-line,8寸开始i-line/DUV了。
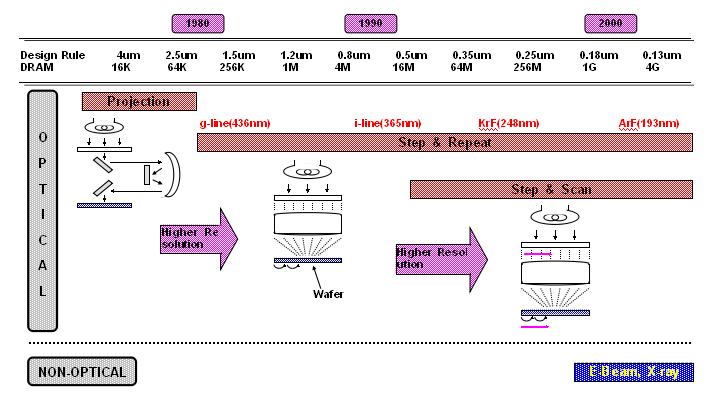

HMDS是一种蒸汽,在Coat光阻之前必须在HMDS蒸气中熏一会,有助于光阻的表面粘附性(Contact Angle),Coat光阻后需要soft_bake,将光阻里面的有机溶剂蒸发掉,然后再去曝光(分stepper和Scanner),曝光完也要PEB烘烤一下,再去显影/烘烤.
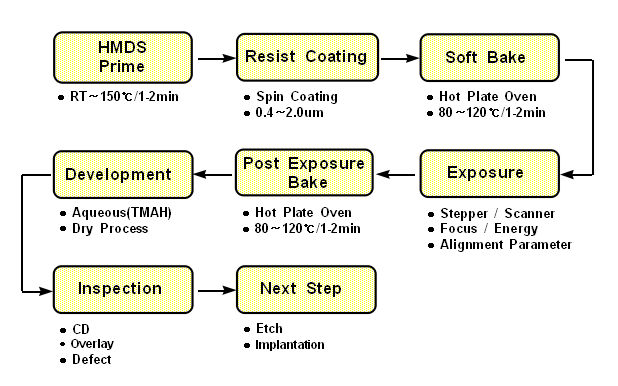
R表示Resolution,是指最小成像的线宽,所以越小越好
DOF表示胶深(Depth_of_Focus),表示能够曝光穿透的光阻厚度,所以当然是越深可以容忍的光阻越厚。
所以在 实际情况下,R和DOF总是互相抑制并寻求最理想情况。
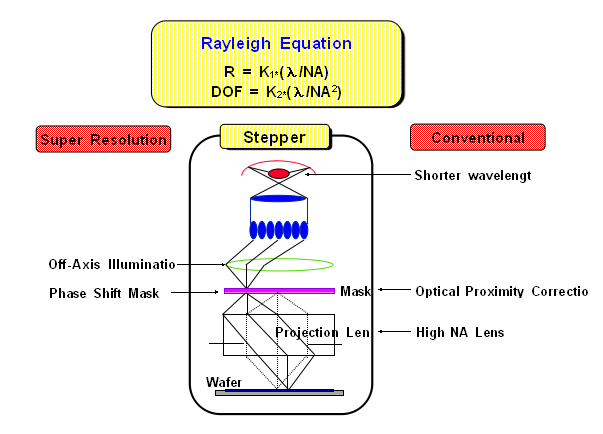
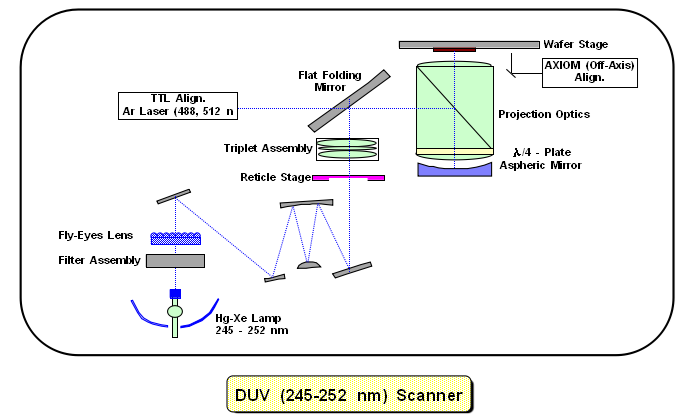
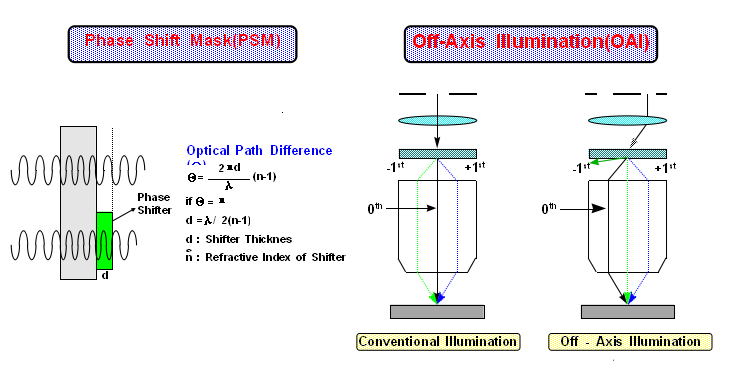
《专题-1: Unit Process–Photolithography (转)》.doc
将本文下载保存,方便收藏和打印
导出文档

 支付宝打赏
支付宝打赏  微信打赏
微信打赏