STI与LOCOS工艺对比及应用分析
STI(Shallow Trench Isolation,浅槽隔离)和LOCOS(Local Oxidation of Silicon,局部氧化硅)是集成电路制造中两种常见的器件隔离技术。它们在工艺步骤、性能特点和应用场景上存在显著差异,以下是两者的对比分析:
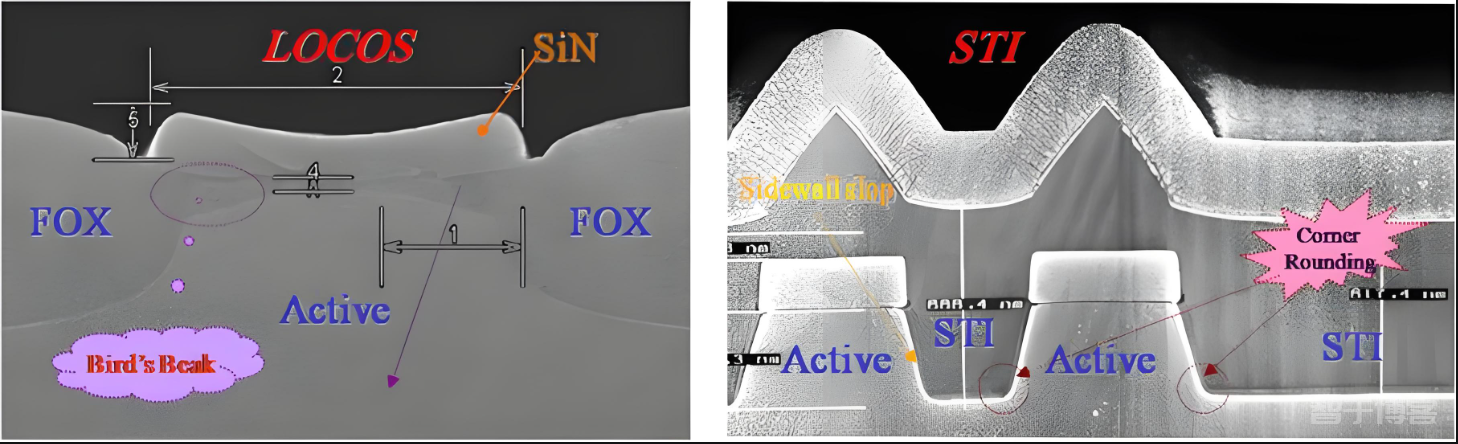
1. 工艺原理对比
LOCOS(局部氧化硅)
工艺步骤:
在硅衬底上沉积氮化硅(Si₃N₄)作为掩模。
通过光刻和刻蚀形成隔离区域的图形。
高温氧化(~1000°C)使未被氮化硅覆盖的区域生长二氧化硅(SiO₂),实现器件间的隔离。
去除氮化硅掩模。
关键特点:
鸟嘴效应(Bird's Beak):氧化过程中SiO₂会横向扩展,导致隔离区域边缘变宽,占用额外面积。
热应力:高温氧化可能引入缺陷,影响器件可靠性。
工艺简单,成本较低,但隔离精度和密度有限。
STI(浅槽隔离)
工艺步骤:
在硅衬底上沉积氮化硅和氧化硅作为硬掩模。
通过光刻和干法刻蚀在硅中形成浅槽(深度通常为0.3-0.5μm)。
填充高密度等离子体氧化物(HDP Oxide)或化学气相沉积(CVD)氧化物。
化学机械抛光(CMP)平坦化表面,去除多余材料。
关键特点:
无鸟嘴效应:隔离边界清晰,节省面积,适合高密度集成。
低温工艺:减少热应力,提升器件可靠性。
工艺复杂,需CMP和高精度刻蚀技术,成本较高。
点击阅读全文
《STI与LOCOS工艺对比及应用分析》.doc
将本文下载保存,方便收藏和打印
导出文档
