GaN器件之全面介绍
今天这篇,从材料、历史、结构、应用和竞争五个方面,对GaN器件做一全面总结,4000字长文预警。
(1)GaN器件简介:
从器件结构看,GaN器件分为横向(Lateral)、纵向(Vertical)两种,
可以简单认为,横向器件的电流流动限于半导体材料表面,纵向器件的电流流动穿透整块半导体材料,
结果是,纵向器件的击穿电压更高,可应用于更高耐压级别。
目前商用GaN器件均为横向器件,纵向GaN器件基本仍处于实验室阶段。

图片来源:网络
这是几种常见的SiC器件、GaN器件,
(a)、(b)、(c)依次为平面型SiC MOSFET、沟槽型SiC MOSFET以及SiC JFET,
(d)、(e)均为GaN HEMT,
注意5张图中的电极,SiC器件和GaN器件,G、D、S的位置,有重大差异,
三种SiC器件,漏极D在最下方,栅极G、源极S在最上方,
而两种GaN器件,G、D、S均在最上方,
简言之,横向器件的G、D、S均在最上方,纵向器件的G、S在最上方,D在最下方,这是核心差异。
具体到GaN器件,横向、纵向有何差异?
纵向GaN功率器件最早由加州大学圣塔芭芭拉分校于2002年实现,2008年制备出高压器件,目前日美研究机构正在积极推进该类器件的研发,
随着GaN衬底价格的下降,纵向GaN器件的应用场景将逐渐增多。
纵向GaN器件一大优势在于,器件内部电场分布更均匀,其工作电场强度更接近击穿电场理论极限。
传统观点认为,GaN器件欲进军1200V耐压市场,只能依靠纵向结构。
因为横向GaN器件市场建立在硅基氮化镓(GaN-on-Si)技术之上,Si衬底成本低、尺寸大,是规模化生产的自然选择,
但在高压下,导电硅衬底使器件漏极和衬底之间容易发生击穿,从而限制横向GaN器件的耐压能力。
但2022年瑞萨(Renesas)提供了一种方案,可通过横向器件实现1200V耐压。
即,于蓝宝石衬底之上外延生长氮化镓材料(GaN-on-sapphire),制备GaN HEMT,
蓝宝石的绝缘特性消除了漏极与衬底之间的击穿问题,使其能实现1200V耐压,
另一巧妙之处在于,相比纵向器件,横向器件的芯片面积更大(因为要靠水平方向扩展的漂移区承担耐压),这本是横向器件的劣势,
但在GaN-on-sapphire中,这反而成为优势——大芯片面积可缓解蓝宝石高热阻率导致的散热困难问题。
GaN-on-sapphire方案保留了横向HEMT固有的二维电子气高迁移率,从而具有低存储电荷、高速开关之能力,
且蓝宝石的高电阻率特性,使该器件可以使用厚度更薄的III族氮化物缓冲层,外延成本因之降低。
至于蓝宝石衬底相关工艺,GaN LED(发光二极管)主要采用这种衬底,已有数十年产业链经验可供借鉴。
瑞萨已推出70 mΩ蓝宝石基GaN cascode器件,TO-247 封装,
在50 kHz工作频率下、900V转450V降压转换器中,器件效率超99%,极具竞争力。
此外,未来十年,N极性氮化镓高电子迁移率晶体管(N-Polar GaN HEMT)与超结技术(Superjunction),将推动横向GaN功率器件持续发展。
前者将器件的晶体取向从传统的Ga极性翻转为N极性,获得更优的电子控制能力,
后者则是对耐压层进行改进,以交替排列的N柱和P柱代替单一类型掺杂的耐压层。
横向GaN器件的发展不仅会与碳化硅(SiC)器件竞争,也将挑战氧化镓(Ga2O3)、氮化铝(AlN)等超宽禁带半导体(UWBG)的市场地位。
(2)GaN器件历史回顾:
介绍完器件结构,再看发展历程,
1、第一阶段:1993~2007
1993年,Khan发明铝镓氮/氮化镓高电子迁移率晶体管(AlGaN/GaN HEMT),
1996年,加州大学圣塔芭芭拉分校(UCSB)制备GaN微波功率器件,
这两项成果确立了GaN作为电力电子领域潜力材料的地位。
1999年,Nitres公司、康奈尔大学与Cree公司(现更名Wolfspeed)各自独立发明氮化硅钝化技术,用于控制电流崩塌效应。
此后,加州大学圣塔芭芭拉分校接连取得一系列技术突破:
2000年,研制千伏级AlGaN/GaN HEMT,
2001年,发明AlGaN/AlN/GaN结构设计,该设计如今广泛应用于多数HEMT,
2004年,发明场板(field plates)技术,用于抑制高压下的电流崩塌效应,目前已成为多数应用场景HEMT的标准配置,
2006年亦有两项关键发明:
加州大学圣塔芭芭拉分校研发出具备常关(normally-off)功能的p型栅器件,松下公司(Panasonic)推出栅注入晶体管(GIT),
这两项发明为GaN器件进入功率与射频(RF)市场奠定基础。
2、第二阶段:2007~2019
常关功能的实现至关重要,
业界所谓fail-safe power applications,直译“故障导向安全应用”,
大意是,任何单一故障发生时,系统必须自动进入安全状态(通常为关断/零功率输出),
常开型器件,0V驱动下处于导通状态,可能形成浪涌电流,导致系统失控,
常关型器件,栅极驱动失效时,器件自然关断,功率路径切断,符合安全原则。
因此,功率晶体管欲实现商业化,要求之一便是常关型。
2006年GaN器件实现常关功能后,商业化开始落地,
日本松下(Ueda团队)、富士通(Kikkawa团队,后与美国Transphorm合并),美国国际整流器公司(International Rectifier,现属英飞凌)、
德州仪器(Texas Instruments)、Power Integrations,以及 EPC、Transphorm(现属瑞萨)、Navitas等企业,均有布局,
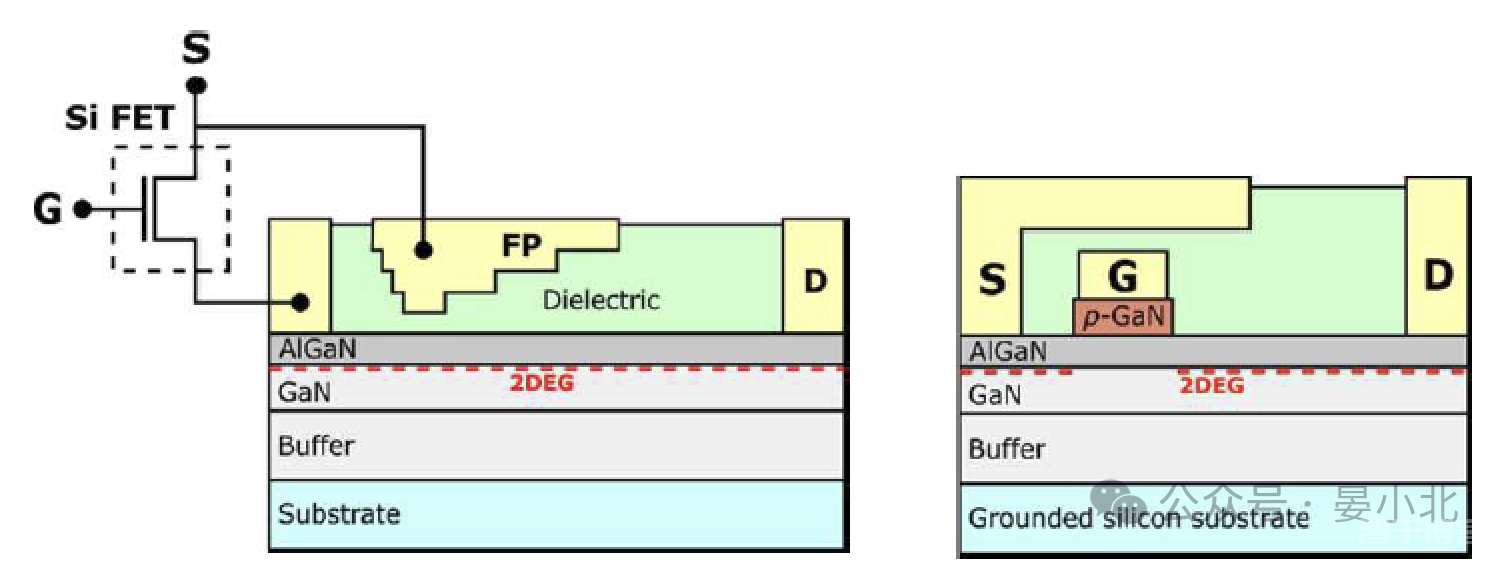
图片来源:网络
如今的GaN器件产品,为实现常关功能,主要有两种方案,
1、p-GaN栅极堆叠,
2、共源共栅结构(cascode),
如上,左图为cascode,右图为p-GaN堆叠,
简单解释原理,
cascode将Si MOSFET与GaN HEMT串联,通过Si MOSFET控制GaN HEMT沟道的开关,
Si MOSFET的源极,接GaN HEMT的栅极,
驱动电压为0,HEMT栅极通过Rg下拉至负电压,使得沟道关断,
驱动电压大于0,HEMT栅极被拉至Si MOSFET源极电位,沟道开启。
p-GaN栅极堆叠是在AlGaN之上,生长p型GaN(掺Mg),栅金属与p型GaN形成肖特基接触,
零栅压下,p型GaN的空穴与AlGaN/GaN界面的2DEG电子复合,降低沟道电子浓度,实现常关。
3、第三阶段:2020至今

