半导体行业入门学习笔记分享
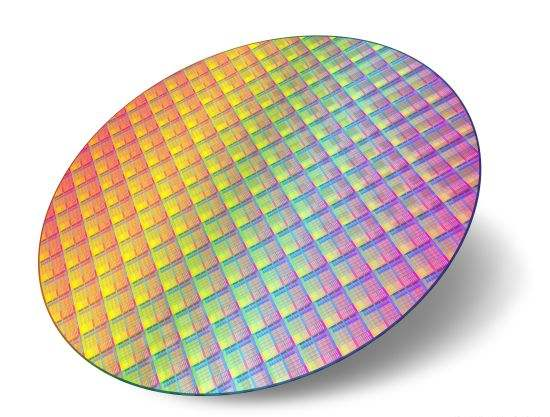
硅片的制备:
生产半导体级的硅(SGS)
1. 用碳加热硅石制备冶金级的硅
SiC(s)+SiO2(s)——Si(l)+SiO(g)+CO(g)
2. 将硅提纯生成三氯硅烷
Si(s)+3HCI(g)——SiHCI3(g)+H2(g)+加热
3. 利用西门子方法,通过三氯硅烷和氢气反应生成SGS
2SiHCI3(g)+2H2(g)——2Si(s)+6HCI(g)
生长单晶硅
CZ法:把融化了的半导体级硅液体变为有正确晶向的固体硅锭。
区熔法:纯度高,直径小。
更大的晶圆——更高的生产效率和更高的生产成品率
成品率=好芯片/总芯片
硅片中的晶体缺陷
点缺陷:空位缺陷、间隙原子缺陷、Frenkel缺陷(受生长速率和温度梯度影响)
位 错:不均匀的受冷或者受热以及超过硅片承受范围的应力
层 错:生产过程中的热影响或机械振动
点击阅读全文
《半导体行业入门学习笔记分享》.doc
将本文下载保存,方便收藏和打印
导出文档
