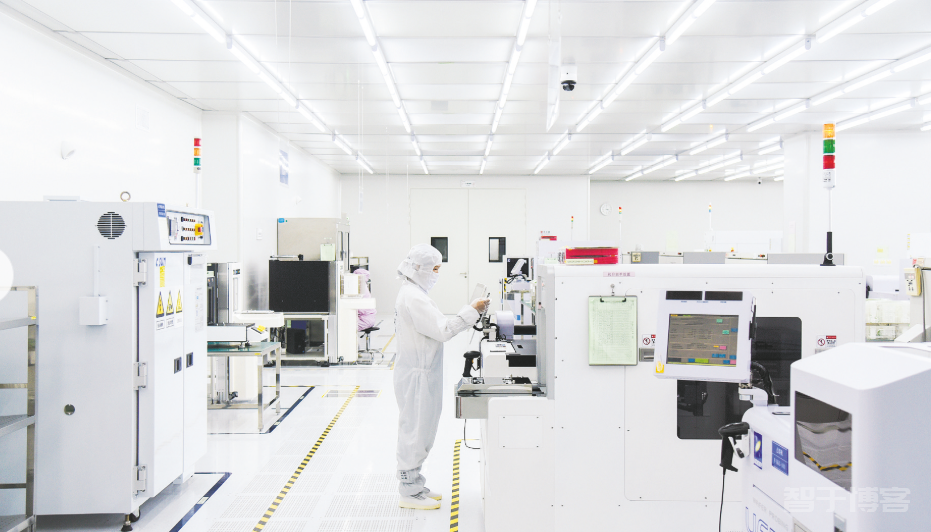
晶圆级老化测试(Wafer Level Burn-In, WLBI)是针对 SiC 晶圆的高温高压加速应力测试技术,通过在封装前模拟极端工作条件(如高温、高电压),筛选出早期失效的芯片,从而显著降低后续封装和系统级应用的风险。对于车规级 SiC 器件,WLBI 尤为关键 —— 例如,联讯仪器的 WLBI3810 系统可同时对 9 片 SiC 晶圆进行 ** 高温栅极偏压(HTGB)和高温反向偏压(HTRB)** 测试,确保封装后的模组满足 AEC-Q101 等严苛标准。
SiC WLBI 的工艺核心是通过加速应力暴露材料与工艺缺陷,主要包括以下步骤:
应力施加
HTGB 测试:对栅极施加高于正常工作电压的应力(如 ±100V),持续数小时至数千小时,以检测栅氧化层缺陷(如界面陷阱)和阈值电压(Vth)漂移。
HTRB 测试:在漏极 - 源极间施加高反向电压(如 2000V),评估 PN 结或肖特基势垒的可靠性,筛选出漏电通道或边缘击穿等隐患。
温度协同:测试温度通常在 150°C 至 200°C 之间,通过热激活加速缺陷演化,例如广立微 WLBI B5260M 系统可实现晶圆面内 ±1°C 的温度均匀性。
参数监测与保护
数据驱动筛选